Etsning:
Två elektroder finns tillgängliga för etsningsprocesser:
■ Elektrod med brett temperaturområde (-150°C till +400°C), kyld med flytande kväve, flytande cirkulerande köldmedium eller motstånd med variabel temperatur. Valfri renings- och vätskebytesenhet för att automatiskt byta processläge.
■ Vätskestyrd elektrod tillförd av cirkulerande kylenhet.
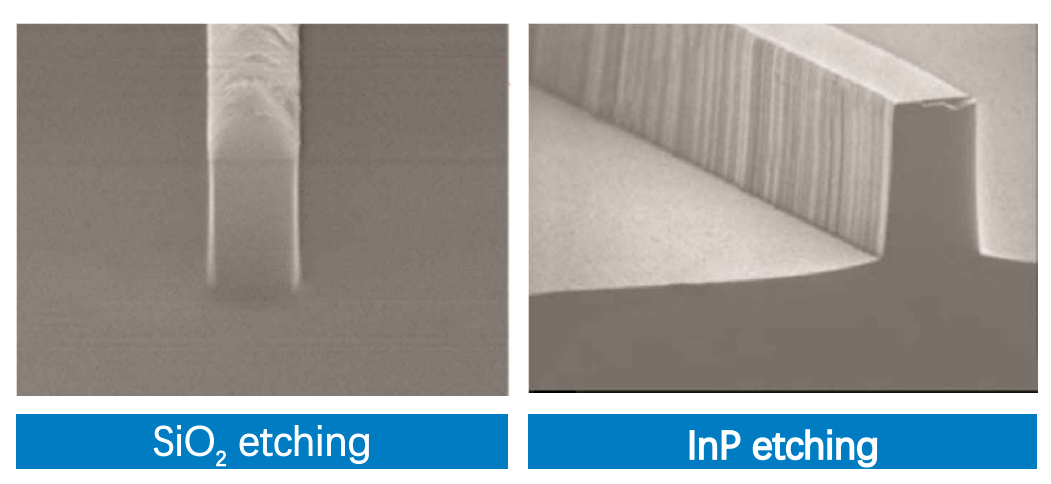
Deposition:
Två elektroder finns tillgängliga för val av avsättningsprocess:
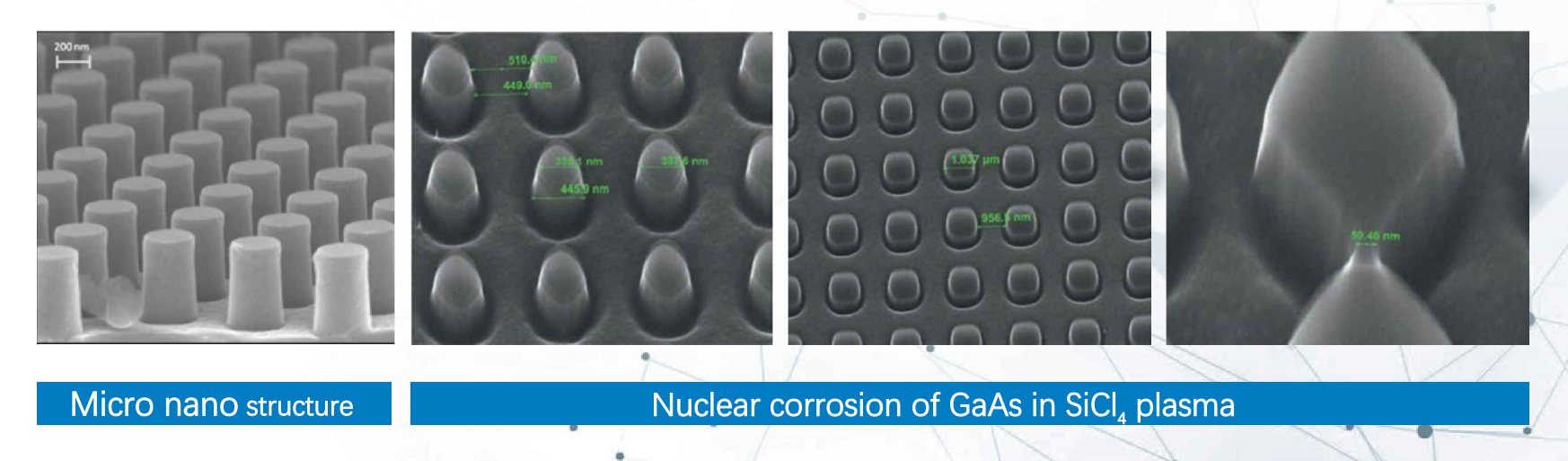
Reaktiv jonetsning (RIE)
RIE är en enkel och ekonomisk plasmaetsningslösning, med vanliga applikationer som masketsning och felanalys.
RIE-funktioner:
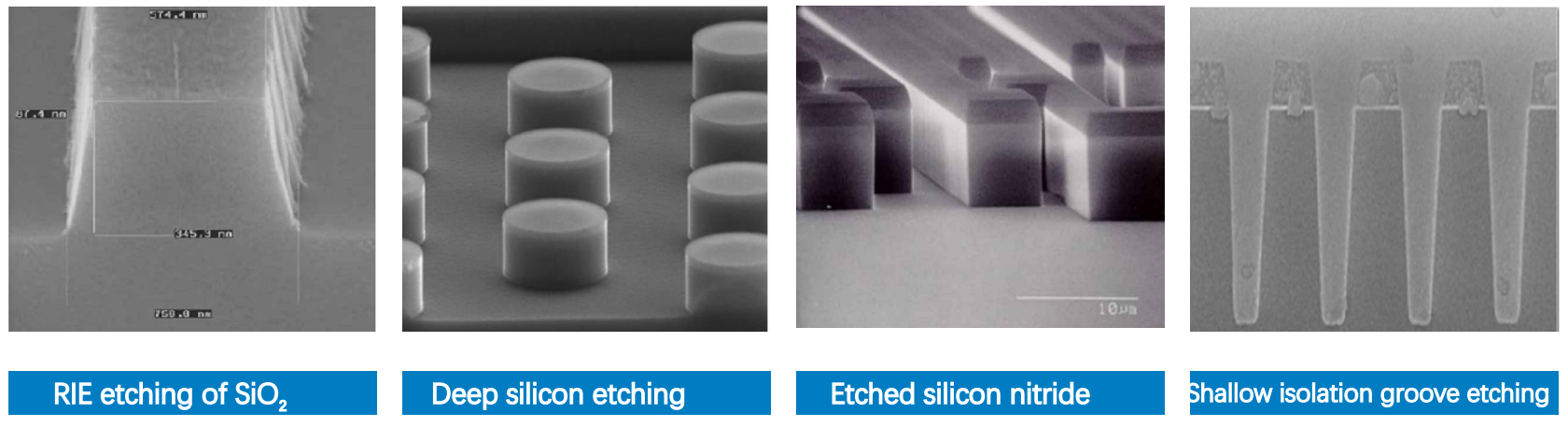
Induktivt kopplad plasmaetsning (ICP)
ICP-etsningskällan producerar aktiva reaktiva joner med hög densitet vid lågt tryck.
ICP Etsningsfunktioner:
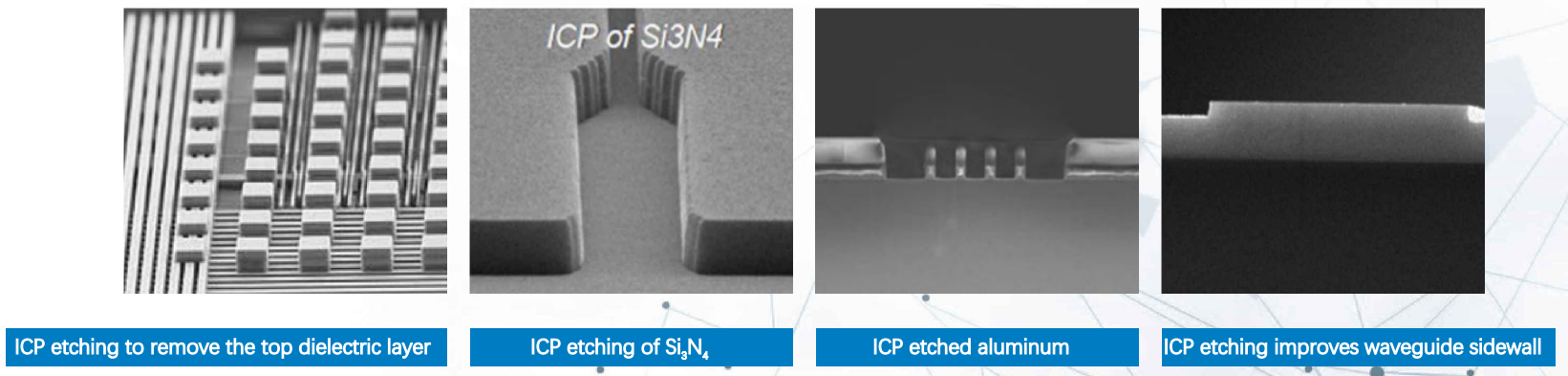
Plasma Enhanced Chemical Vapor Deposition (PECVD):
PECVD-processmodulerna är speciellt utformade för att producera tunna filmer med utmärkt enhetlighet och höga avsättningshastigheter, och för att modifiera filmernas materialegenskaper, såsom brytningsindex, spänning, elektriska egenskaper och våtetsningshastigheter.
PECVD funktioner:
Den optimerade övre elektroden, som arbetar under hög spänning, hög RF-effekt och höga flödesförhållanden, kan accelerera avsättningshastigheten för SiO2, Si3N4, SiON och amorft Si samtidigt som filmprestanda och wafer-likformighet säkerställs.
RF-processgasanordning, med motsvarande gasleveransdesign, ger enhetlig plasmaprocess genom LF/RF-omkopplare, och kontrollerar därigenom filmspänningen exakt.
Induktivt kopplad plasmakemisk ångdeposition (ICP / CVD)
ICP/CVD-processmodulen används för att avsätta tunna filmer av hög kvalitet med högdensitetsplasma vid lågt avsättningstryck och låg temperatur.
ICP/CVD-funktioner:

Copyright © Guangzhou Minder-Hightech Co.,Ltd. Alla rättigheter reserverade