การแกะสลัก:
มีอิเล็กโทรด 2 ตัวสำหรับกระบวนการกัด:
■ อิเล็กโทรดที่มีช่วงอุณหภูมิกว้าง (-150°C ถึง +400°C) ระบายความร้อนด้วยไนโตรเจนเหลว สารทำความเย็นหมุนเวียนของเหลว หรือตัวต้านทานอุณหภูมิที่ปรับได้ มีหน่วยการเป่าและแลกเปลี่ยนของเหลวเสริมเพื่อสลับโหมดกระบวนการโดยอัตโนมัติ
■ อิเล็กโทรดควบคุมของเหลวที่จ่ายโดยหน่วยระบายความร้อนแบบหมุนเวียน
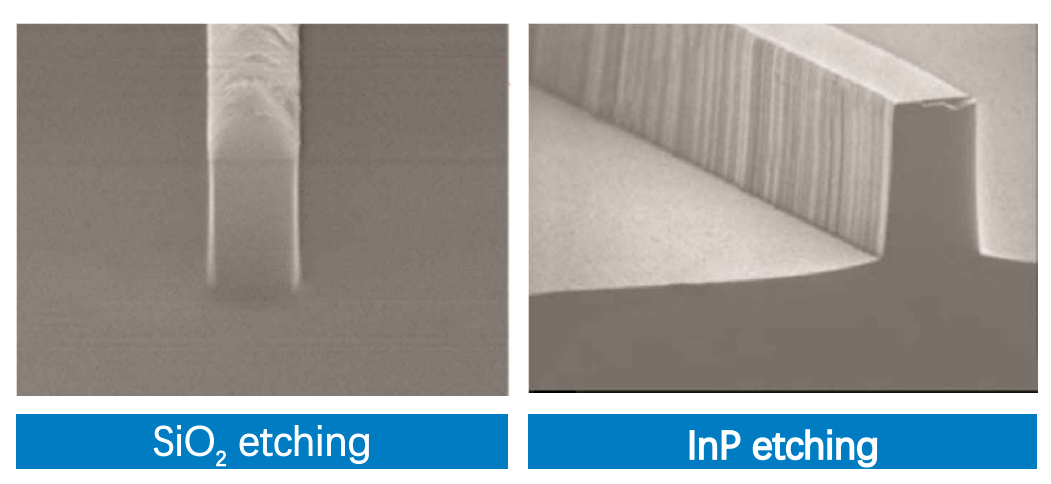
การสะสม:
มีอิเล็กโทรด 2 ตัวสำหรับการเลือกกระบวนการการสะสม:
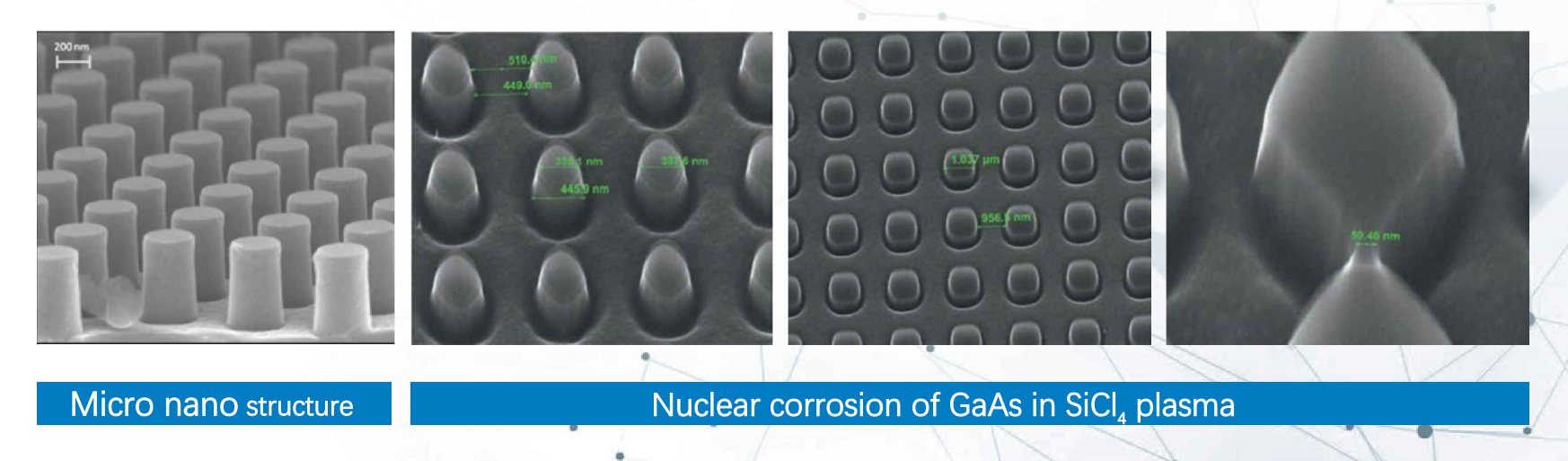
การกัดไอออนแบบปฏิกิริยา (RIE)
RIE เป็นโซลูชันการกัดพลาสมาที่เรียบง่ายและประหยัด ซึ่งมีการใช้งานทั่วไป เช่น การกัดมาส์ก และการวิเคราะห์ความล้มเหลว
คุณสมบัติของ RIE:
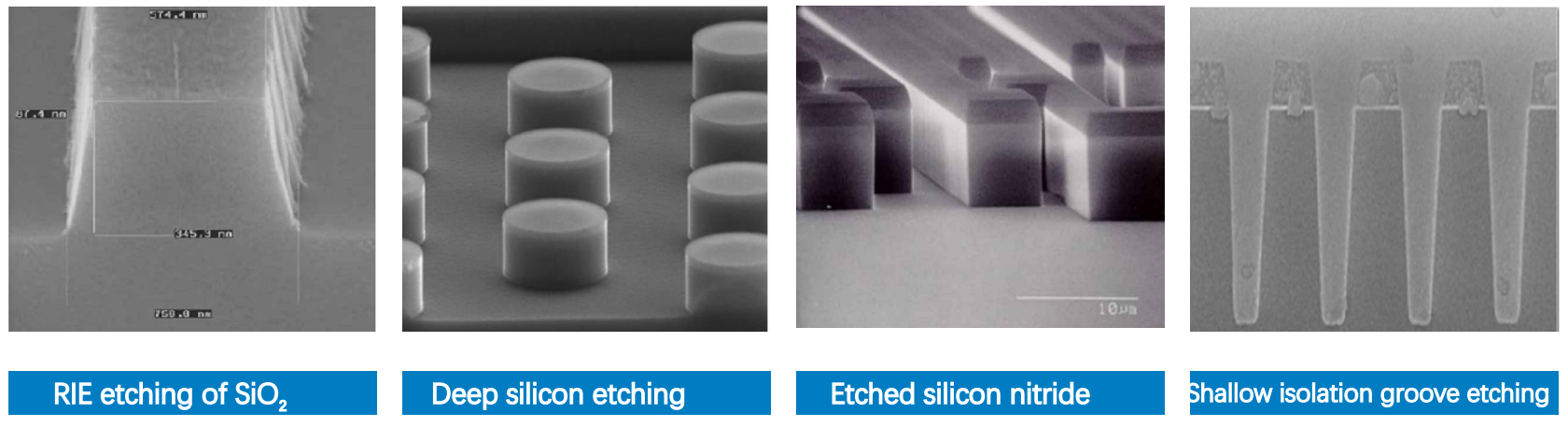
การกัดพลาสมาแบบเหนี่ยวนำแบบมีการเชื่อมต่อ (ICP)
แหล่งการกัด ICP สร้างไอออนปฏิกิริยาที่มีความหนาแน่นสูงที่ความดันต่ำ
คุณสมบัติการแกะสลัก ICP:
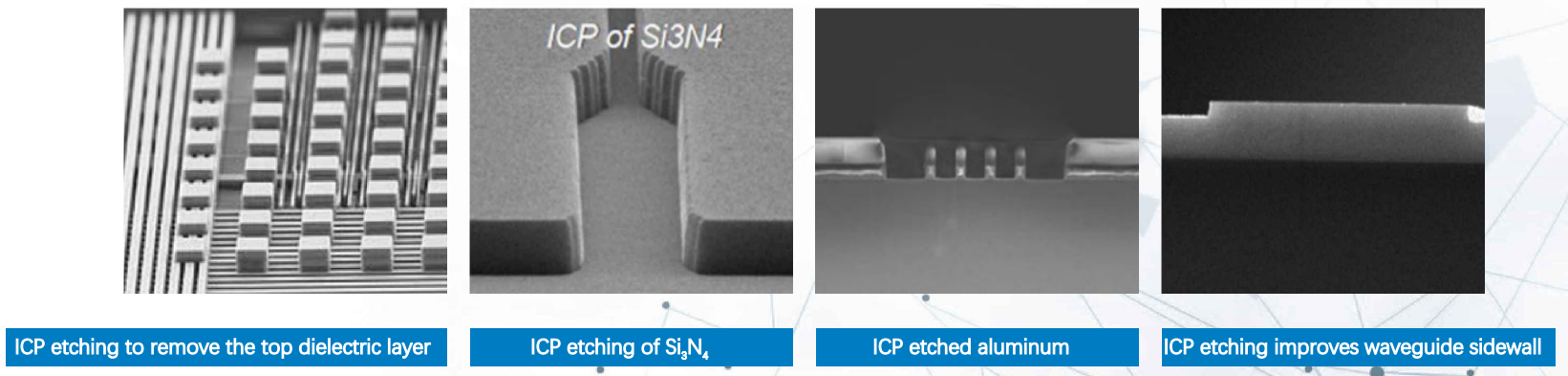
การสะสมไอเคมีที่เพิ่มประสิทธิภาพด้วยพลาสมา (PECVD):
โมดูลกระบวนการ PECVD ได้รับการออกแบบมาโดยเฉพาะเพื่อผลิตฟิล์มบางที่มีความสม่ำเสมอที่ยอดเยี่ยมและอัตราการสะสมที่สูง และเพื่อปรับเปลี่ยนคุณสมบัติของวัสดุของฟิล์ม เช่น ดัชนีการหักเหของแสง ความเครียด คุณสมบัติทางไฟฟ้า และอัตราการกัดแบบเปียก
คุณสมบัติของ PECVD:
อิเล็กโทรดด้านบนที่ได้รับการปรับให้เหมาะสม ซึ่งทำงานภายใต้แรงดันไฟฟ้าสูง กำลัง RF สูง และสภาวะการไหลสูง ช่วยเร่งอัตราการสะสมของ SiO2, Si3N4, SiON และ Si อะมอร์ฟัสได้ พร้อมทั้งยังรับประกันประสิทธิภาพของฟิล์มและความสม่ำเสมอของเวเฟอร์อีกด้วย
อุปกรณ์ก๊าซกระบวนการ RF ที่มีการออกแบบการส่งก๊าซที่สอดคล้องกัน ช่วยให้กระบวนการพลาสมาสม่ำเสมอผ่านสวิตช์ LF/RF จึงควบคุมความเค้นของฟิล์มได้อย่างแม่นยำ
การสะสมไอเคมีของพลาสมาที่เหนี่ยวนำโดยการจับคู่ (ICP / CVD)
โมดูลกระบวนการ ICP/CVD ใช้ในการสะสมฟิล์มบางคุณภาพสูงโดยใช้พลาสมาความหนาแน่นสูงภายใต้ความดันและอุณหภูมิการสะสมต่ำ
คุณสมบัติของ ICP/CVD:

ลิขสิทธิ์ © Guangzhou Minder-Hightech Co.,Ltd. สงวนลิขสิทธิ์