תַחרִיט:
שתי אלקטרודות זמינות לתהליכי תחריט:
■ אלקטרודה עם טווח טמפרטורות רחב (-150°C עד +400°C), מקורר על ידי חנקן נוזלי, נוזל קירור במחזור או נגד טמפרטורה משתנה. יחידת טיהור והחלפת נוזלים אופציונלית למעבר אוטומטי של מצב תהליך.
■ אלקטרודה מבוקרת נוזל מסופקת על ידי יחידת קירור במחזור.
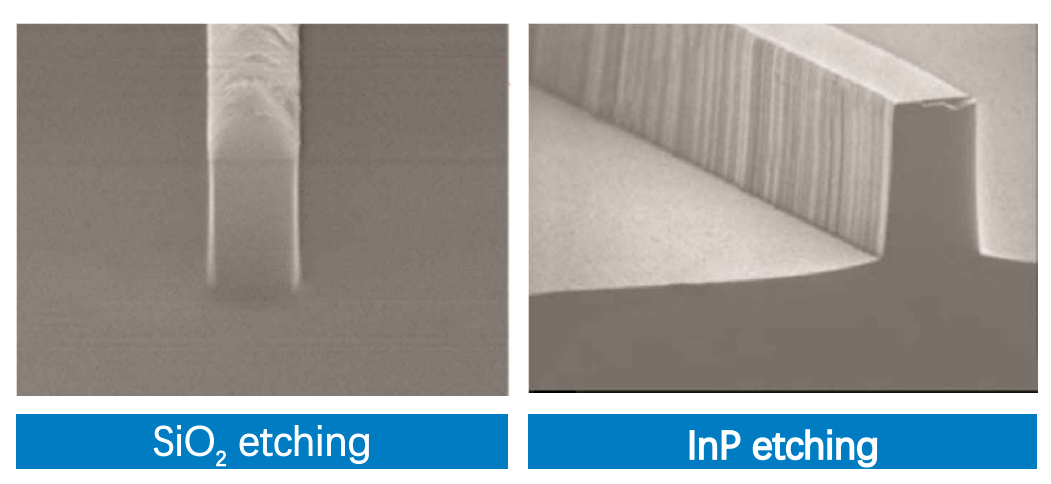
תַצהִיר:
שתי אלקטרודות זמינות לבחירת תהליך השקיעה:
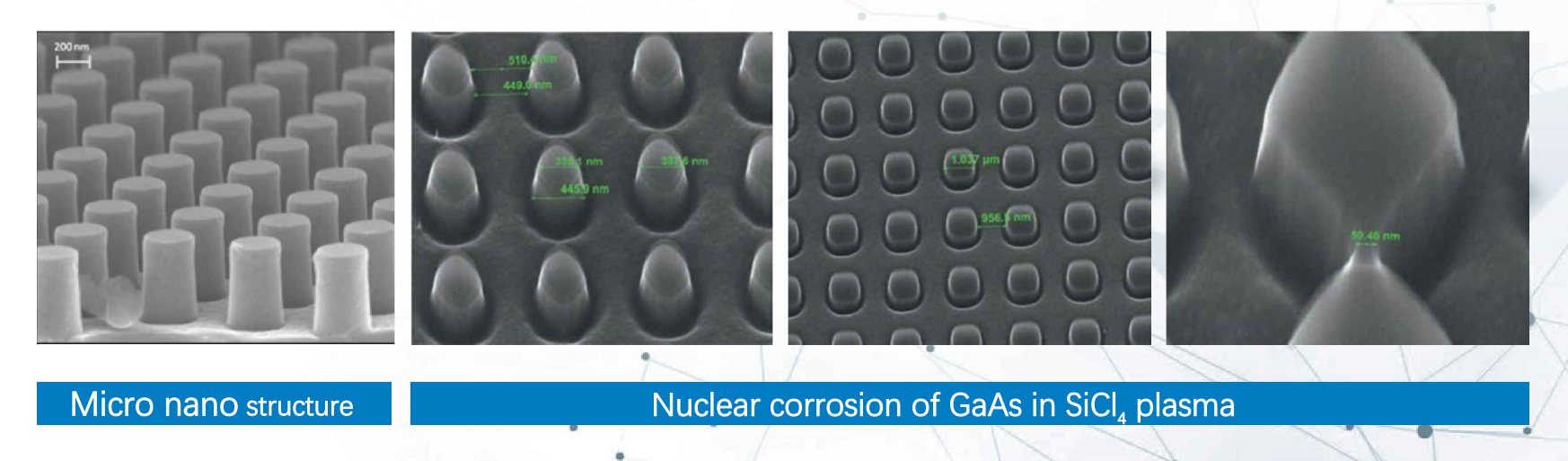
תחריט יונים תגובתיים (RIE)
RIE הוא פתרון תחריט פלזמה פשוט וחסכוני, עם יישומים נפוצים כמו תחריט מסכה וניתוח כשל.
תכונות RIE:
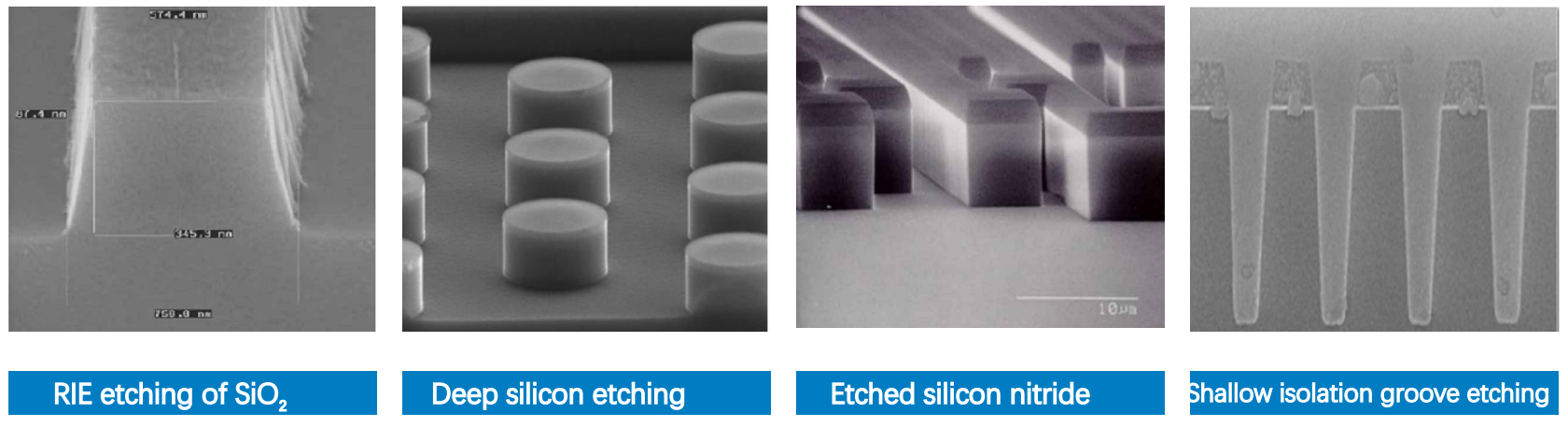
תחריט פלזמה (ICP) בשילוב אינדוקטיבי
מקור התחריט של ICP מייצר יונים תגובתיים פעילים בצפיפות גבוהה בלחץ נמוך.
תכונות תחריט ICP:
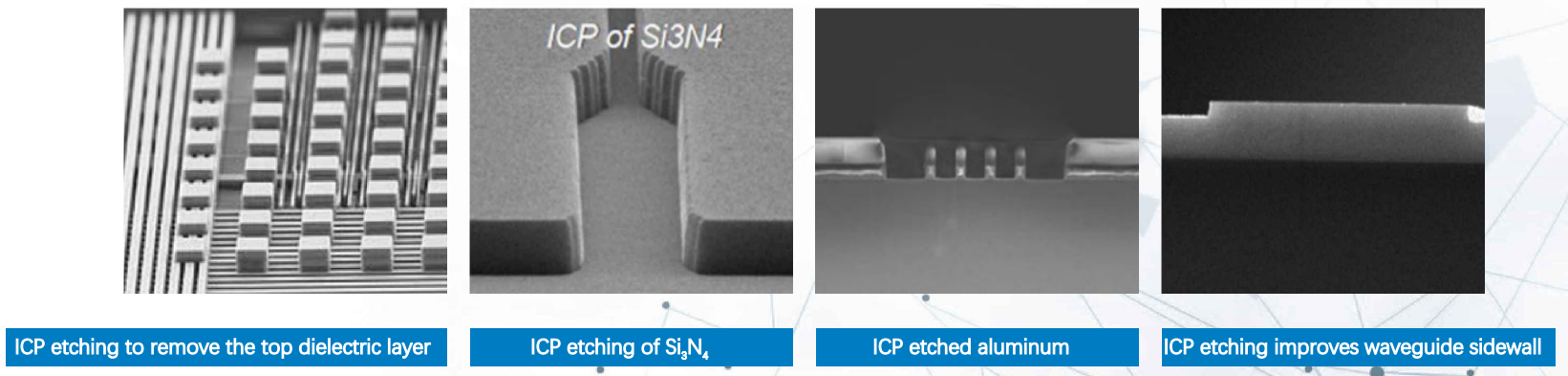
שקיעת אדים כימית משופרת בפלזמה (PECVD):
מודולי תהליך ה-PECVD תוכננו במיוחד כדי לייצר סרטים דקים עם אחידות מצוינת וקצבי שקיעה גבוהים, וכדי לשנות את תכונות החומר של הסרטים, כגון מקדם שבירה, מתח, תכונות חשמליות ושיעורי חריטה רטובה.
תכונות PECVD:
האלקטרודה העליונה האופטימלית, הפועלת במתח גבוה, הספק RF גבוה ותנאי זרימה גבוהים, יכולה להאיץ את קצב השקיעה של SiO2, Si3N4, SiON ו-Si אמורפי תוך הבטחת ביצועי הסרט ואחידות פרוסות.
מכשיר גז לתהליך RF, עם תכנון אספקת גז מתאים, מספק תהליך פלזמה אחיד באמצעות מתג LF/RF, ובכך שולט במדויק על מתח הסרט.
שקיעת אדים כימית בפלזמה (ICP / CVD) בשילוב אינדוקטיבי
מודול תהליך ICP/CVD משמש להפקדת סרטים דקים באיכות גבוהה תוך שימוש בפלזמה בצפיפות גבוהה בלחץ ובטמפרטורה נמוכים.
תכונות ICP / CVD:

זכויות יוצרים © Guangzhou Minder-Hightech Co., Ltd. כֹּל הַזְכוּיוֹת שְׁמוּרוֹת